
안녕하세요! 인생루틴입니다.
반도체 단위 공정 중 Photo 공정에 대해 설명해보는 시간을 가져보도록 하겠습니다.
Photo(Litho [돌]+Graphy [인쇄]) 공정: 반도체 Layer는 Photo 공정이 기준
1. Lithography
Photo Mask 상에 설계된 소자의 패턴(Pattern)을 웨이퍼 상에 구현(이온주입/식각 공정의 선행 공정)
2. 공정의 특징 : 반도체 핵심기술
모든 프로세스 기술의 중심, 가장 많은 금액의 장비 투자가 필요한 공정
Photo 공정 순서
HMDS 처리 (기판/PR 접착력 향상) → PR Coating (Spin Coating) → Soft Bake (PR 內 Solvent 휘발)
→ Mask Align (Mask 정렬) → Exposure (노광 공정) → PEB (감광제 확산/노광 경계)
→ Develop (Pattern 현상) → Hard Bake (건조/PR Rough 감소)
① HMDS 처리 : Wafer와 PR 간의 접착력 향상 (친수성을 소수성으로)
목적 : 웨이퍼의 표면을 화학 처리하는 HMDS(Hexa Methyl Di Silazane) 처리
웨이퍼의 표면에 HMDS Gas 분사를 통하여 Si-O-H 형태의 친수성인 웨이퍼 표면을 소수성으로 바꾸어 주어
웨이퍼와 PR(감광제)의 접착력을 향상
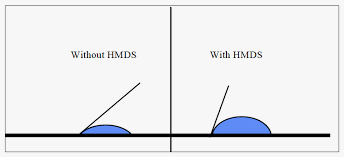
원리 : Photoresist, PR(감광제)의 성분은 대부분 유기용매[기름]
- 친수성의 Wafer에 PR이 잘 접착이 되지 않음
- HDMS 처리 후 도포 용이/접착력 향상
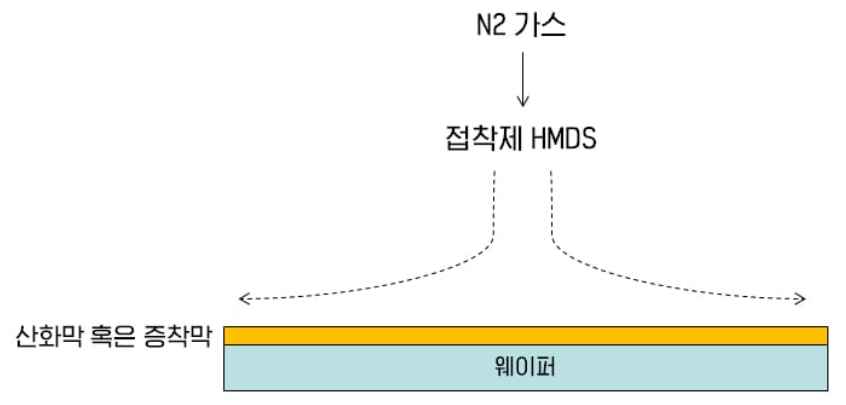
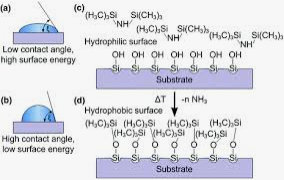
② Photo Resist Coating : 감광액 도포
PR 역할 및 구성 : 미세 패턴의 형성 및 Etch / Ion Implant 표면 보호
- organic Solvent : 용액화 / 점도 결정, Spin / Bake에서 제거
- base Resin : 빛과 무반응, PR 접착력 / 에칭 저항력 향상, 현상액에 잘 용해
- Photoactive Compound : 단파장 빛에 의해 파괴 [Positive]

PR 도포 메커니즘 : Spin coating 방식을 이용하여 코딩
Wafer 회전 → 감광제 도포 → 회전 가속 → Max Speed 유지 → Stop
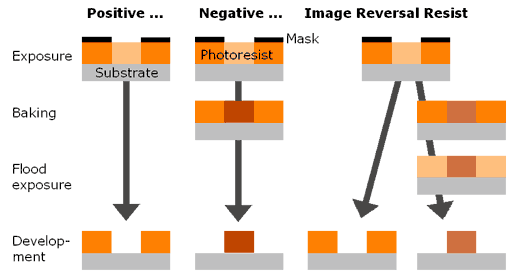
감광액 종류
→ Positive : 광 받은 부분이 제거, 고해상도
→ Negative : 접착력 / 내산성 좋으나, 미세패턴에 부적합

PR Coating 불량
→ Edge Bead : EBR(노광 / Chemical)
→ Steak : PR 內 이물질의 원심력 이동
③ Soft Bake : SOB
목적 : 남아있는 유기 용매(Solvent)를 제거, 접합력 향상
→ 잔류 용매로 인한 노광 설비, 마스크 오염방지, 감광제 반응 특성을 일정하게 유지
방법 : 저온 Bake (90~110°C)
④ Align : 정렬
목적 : Mask를 정확히 선행 Layer와 정렬하는 것 → Align Key 이용(Mask를 정확히 선행 Layer와 정렬하는 것)
→ X-Y Align, Shift / Rotate / Tilt 등 mis-align 방지
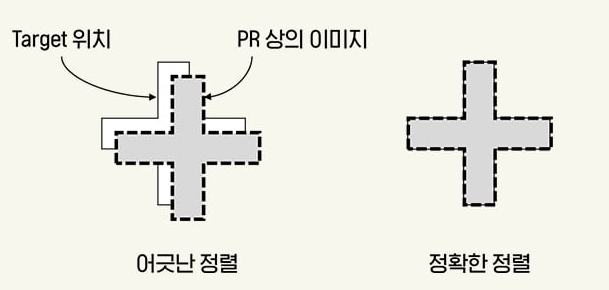


⑤ Exposure : 노광
목적 : Photo Mask에 광을 통과시켜 Silicon 기판 위에 도포된 PR에 패턴을 새기는 공정
* Wafer 당 노광 횟수가 Cost 측면에서 중요

⑥ PEB (Post Exposure Bake) : 노광 후 Bake
목적 : Expose(노광) 후 Bake 작업으로 PR의 확산을 통해 노광 계면의 경계를 짓는 과정으로 패턴 형성에 중요한 작업
→ PR에 열을 가하여 분자 단위의 PR 성분을 재정렬시켜 Resolution을 향상하기 위해 Standing Wave 현상을 제거
* Standing Wave 현상 : 노광 시 광의 파장에 의해 광을 받은 부분과 받지 않은 부분이 파도와 물결(Wave) 치게 되는 현상
방법 : PAC 분해 온도(130°C) 이하, 110~120°C/120"

⑦ Develop : 현상
목적 : 현상액을 뿌려 PR의 노광 된 영역과 노광 되지 않은 영역을 선택적으로 제거해 회로 패턴을 형성하는 공정
방법 : 수용성 알칼리 용액 사용, KOH와 TMAH(Tetra Methyl-Ammonium-Hydroxide)
* Nozzle 방식 : 현상액을 Nozzle로 분사하여 일정 시간 동안 Wafer에 정제시킨 후 DI Water로 세정
* Puddle 방식 : 느린 속도로 Wafer를 spin 하여 약간의 현상액을 뿌려 현상 초기에 제거된 부위를 씻어낸 후 정지 상태에서 웨이퍼 위에 developer를 표면 장력으로 잡아서 현상하는 방식
현상액의 소모량이 적고 uniformity가 우수
⑧ Hard Bake / PDB : Post Develop Bake
목적 : 잔류한 현상액, rinse 액, 세정액 등을 휘발 / 제거하여 PR의 내식각성 / 접착성을 증가시킴 [Etch 대비]
방법 : 패턴의 열변형을 방지하기 위해, PEB 온도(110~120°C)와 비슷한 수준에서 유지 필요




댓글